我们在攻克一个又一个“工业皇冠上的明珠”的路上,又取得了新进展。
而这一次,是半导体工业至关重要的国产 DUV 光刻机。
工业和信息化部 9 月 9 日印发《首台(套)重大技术装备推广应用指导目录(2024 年版)》通知,文件列表包含国产氟化氪光刻机(110nm),和氟化氩光刻机(65nm)的相关内容。

接下来,就带大家来具体了解一下。

01.
DUV 光刻机,新进展
通知中的“中国首台(套)重大技术装备”,是指国内实现重大技术突破、拥有知识产权、尚未取得明显市场业绩的装备产品,包括整机设备、核心系统和关键零部件等。
本次列出的包括氟化氪(KrF)和氟化氩(ArF)光刻机。

氟化氪(KrF)和氟化氩(ArF)两种气体均服务于深紫外(DUV)光刻机。
目前来说,光刻机共经历了五代的发展,从最早的 436nm 波长,再到第二代光刻机开始使用波长 365nm i-line,第三代则是 248nm 的 KrF 激光。第四代就是 193nm 波长的 DUV 激光,这就是 ArF 准分子激光。
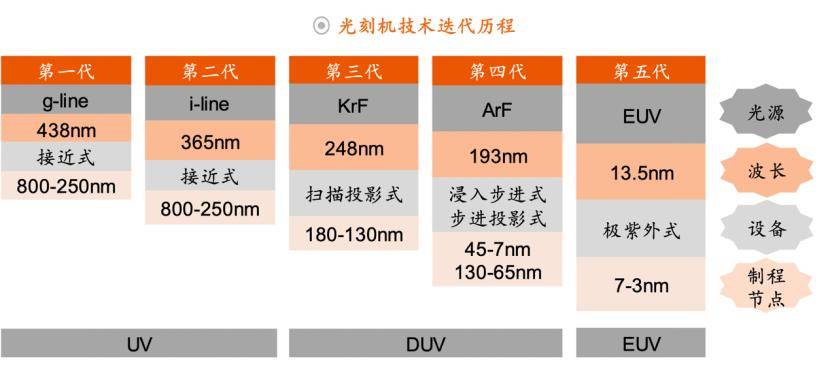
图源:平安证券
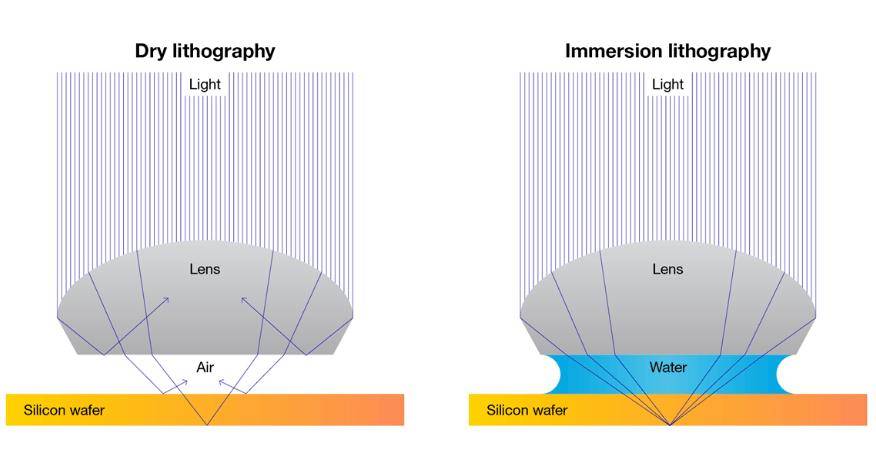
左:干式光刻,右:浸润式光刻
如果再用上浸润式技术下,由于液体的折射效应,ArF(氟化氩)准分子激光源波长可以缩短为 134nm,最高可实现 7nm 制程节点。

而在此之前,技术最先进的国产光刻机应为上海微电子的 SSX600 系列 90nm 光刻机。

02.
套刻精度 ≤8nm,意味着什么
的家友们可能对于“套刻精度 ≤8nm”这个参数有所疑问,这里我们就要从多重曝光工艺聊起。
ASML 浸润式 DUV 光刻机的分辨率为 ≤38nm,但是却可以支撑台积电 N7 工艺的生产,靠的就是多重曝光技术。

常见的多重曝光技术有LELE、LFLE 和 SADP 三种。
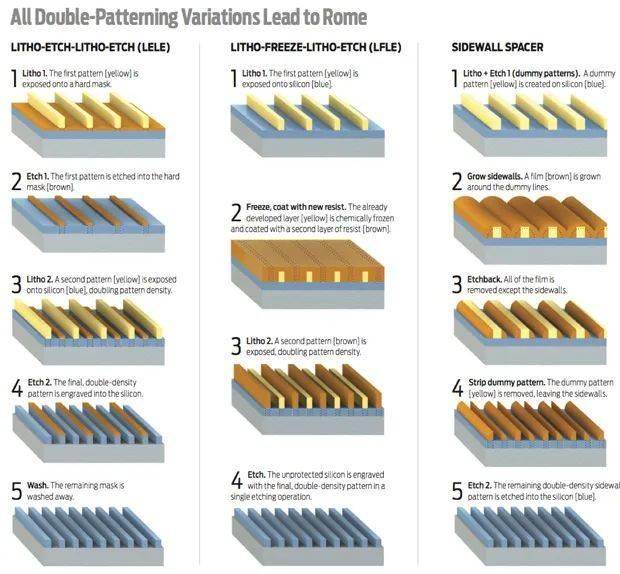
- LELE:光刻 - 刻蚀 - 光刻 - 刻蚀
在同一衬底上顺序进行光刻 - 刻蚀 - 光刻 - 刻蚀工艺,使得图形密度提高一倍。
原来一层光刻图形被拆分到两个或多个掩膜上,实现了图像密度的叠加。
- LFLE:光刻 - 固化 - 光刻 - 刻蚀
LFLE 是 LELE 工艺的一种变体,比 LELE 可节省一道刻蚀步骤。
- SADP:自对准双重图形化
自对准双重图形化 (SADP) 是一种替代传统 LELE 方法的双重图形化工艺,被英特尔应用于 10nm 工艺等。
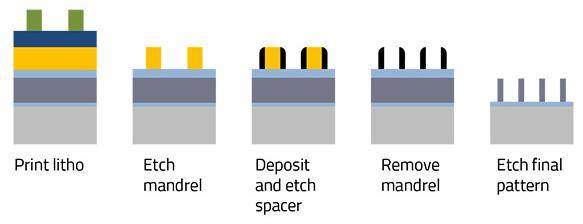
其通过侧墙自对准工艺的双重图形化技术方案,即通过一次光刻和刻蚀工艺形成轴心图形,然后在侧壁通过原子层淀积和刻蚀工艺形成侧墙图形,去除轴心层(即牺牲层),便形成了 pitch 减半的侧墙硬掩模形。
而套刻精度,就是我们常说的“多重曝光能达到的最高精度”。
但是由于多重曝光的成本与良品率问题,≤8nm套刻精度并不一定代表能够生产 8nm 工艺的芯片。

而我们所熟悉的 5nm、3nm 等工艺级别,就需要使用波长 13.5nm 的极紫外 EUV 光源了。

03.
我们的光刻机,跟 ASML 比怎么样?
本次公开的国产氟化氩(ArF)光刻机的性能参数,与 ASML 的 TWINSCAN XT:1460K 较为接近。

并不是所有领域都需要最先进的制程,分辨率 ≤65nm 光刻机的突破,对于家电、汽车等各类工业品来说,仍然有着重大的意义。
我们从 ASML 口中也可以得到相同的答案。

据德国《商报》报道,ASML 的 CEO Christophe Fouquet 今年 7 月接受采访时表示,全球芯片买家,包括德国汽车工业在内,都迫切需要中国芯片制造商目前正大力投资的旧一代电脑芯片。
Christophe 称:“特别是汽车行业,包括德国汽车行业在内,都需要大量使用更简单、更成熟的技术制造的芯片。”
路要一步一步走,我们不应该过分乐观,但也没必要妄自菲薄。
从实现成熟工艺制程芯片的全国产化开始,脚踏实地一步一步走下去,终有一天能够实现先进工艺的突破。
相信在无数国人的努力之下,从DUV 光刻机,走向 EUV 光刻机,也只是时间问题。
对了,别忘了今天还有《苹果 A18 Pro 跑分再曝光,超越 M1》等文章,以及:
未来可期!↓↓↓










 京公网安备 11011402013531号
京公网安备 11011402013531号